Electroless Nickel Plating
Electroless Nickel Plating 
비전해 니켈 도금
팩텍은 웨이퍼 범핑, 패드 재표면처리(와이어본딩), ACF/ACA 적용제품을 위한 비전해 니켈도금 서비스 계약생산을 합니다. 팩텍은 전세계에 걸쳐 4개의 생산기지를 두고 있습니다. 고객의 범핑수요를 충족시킬 수 있는 설비를 갖추고 있습니다. 많은 양의 웨이퍼 범핑 뿐 아니라 프로토타입, 엔지니어링, R&D 프로젝트도 지원합니다. 팩텍 장비는 600,000웨이퍼/년 의 생산용량을 갖고 있습니다.
팩텍은 비전해 Pd와 Gold immersion 프로세스와 함께 비전해 니켈도금으로 다양한 패드 마감재와 층두께를 제공합니다.
1) e-Ni/Au
2) e-Ni/Pd
3) e-Ni/Pd/Au
적용하려는 제품에 따라 2~25µm 니켈의 두께를 조절할 수 있습니다. 팔라듐은 1000~3000A에서, 금은 300 ~1000A 에서 침착됩니다. 팩텍은 고객의 요청에 따라 두께를 조절하여 공급합니다.
Electroless Ni/Au Plating Overview 비전해 Ni/Au 도금 :
Under-Bump-Metallization (UBM) 은 범핑프로세스에서 필수불가결한 부분입니다. UBM 층은 physical vapor deposition (PVD), 전해도금, 비전해 도금될 수 있습니다. 이 세가지 방식은 비용과 신뢰성에 따라 사용방법이 달라지는데, PVD 방식은 고도의 진공상태와 포토리소그라피 과정이 필요하고 비용이 많이 드는 방법입니다. 비전해 Ni/Gold 방식은 자가 패터닝이 가능한 간단한 화학공정입니다. 따라서 초기 시설과 운영의 비용이 낮습니다.
Process Flow: 알루미늄 반도체의 도금
1)패드 클리닝: 유기물, 실리콘산화물, 질소화홥물(용매, 용매화된 산)
2)알루미늄 에칭 : 산화알루미늄 제거(알카라인 에칭)
3)아연도금 1 :알루미늄 활성화
4)아연 제거 : 거친 아연 층 제거(강산)
5)아연도금 2 : 아연 층으로 알루미늄 활성화
6)e-Ni 도금 : 활성화된 Al 본드 패드 위에 선택적으로 니켈 침착(인산 환원제와 황산염 화합물)
7)Au and/or Pd 도금 : 니켈 층 위에 Al and/or Pd 층을 올림(시안화 또는 황산염 화합물)
알루미늄 기반 집적회로의 비전해 니켈도금은 아래와 같은 과정으로 이루어집니다.
1. 패드 위 제조과정 취급 중에 생기는 유기 또는 실리콘화합물질 제거합니다.
2. 알루미늄 패드 표면 위에 생긴 산화물질 제거. 이 과정은 부식성 에칭 화학반응으로 진행됩니다.
3. 알루미늄 표면 활성화. 산화아연 용액에서 전기화학 반응으로 알루미늄을 아연으로 치환하는 반응입니다. 아연층을 벗겨내고 다시 아연화 과정을 거치면 더 우수한 아연층이 생성됩니다. 이 과정을 "double zincation" 이라 합니다. 이 아연 층은 알루미늄 패드의 전기 포텐셜을 변화시키고, 황산니켈용액에 담그면 니켈은 아연을 치환시킵니다. 이 반응은 연속적으로 진행됩니다. 시간, 온도, pH, 니켈의 농도에 따라 1~25마이크론의 두께를 조절할 수 있습니다.
4. 대부분의 경우 니켈 도금이 완성된 뒤에 곧바로 솔더볼을 얹지 않습니다. 그럴 경우 니켈 표면은 아주 빠르게 산화됩니다. 그러므로 순수한 금속이 니켈이 산화되지 않도록 니켈표면 위에 얇게 덮여야 합니다. 그런 역할을 하는 물질이 Pd와 Au 입니다. 두 금속은 비전해 니켈프로세스와 같은 라인에서 담금 또는 비전해식으로 순차적으로 진행될 수 있습니다.
Process Flow: Plating on Copper based semiconductors 구리 기반의 반도체 도금
1)패드 클리닝: 유기물, 실리콘산화물, 질소화홥물(용매, 용매화된 산)
2)산화 구리 에칭 : 산화구리 제거(산 반응)
3)구리 에칭 : 산 반응
4) Pd 촉매 : 구리표면 촉매화(Pd 화학반응)
5)패시베이션 클리닝 : 모든 표면에서 Pd 잔유물 제거(구리 제외)
6)e-Ni 도금 : 활성화된 Al 본드 패드 위에 선택적으로 니켈 침착(인산 환원제와 황산염 화합물)
7)Au and/or Pd 도금 : 니켈 층 위에 Al and/or Pd 층을 올림(시안화 또는 황산염 화합물)
구리 기반 반도체는 알루미늄 반도체와 같은 시설의 니켈, 골드 도금조를 사용합니다. 산 처리 클리닝은 I/O패드 표면에서 산화구리와 잔여 오염물질을 제거합니다. Cu 반도체 도금의 노하우는 주변 패시베이션의 활성화 없이 구리 I/O 패드를 선택적으로 촉매화 하는 데 있습니다.
비전해 도금 과정은 비용이 낮고 플립칩, WLCSP 범핑 외에도 다양한 응용분야에 사용됩니다.
도금의 품질을 결정하는 중요한 세가지 단계는 다음과 같습니다.
1.도금 프로세스 선택,
2.니켈의 형태, 구조,
3.알루미늄(구리) 패드에 니켈의 접착
최선의 니켈 도금 구조는 제련도, 균일도, 얇은 촉매(Zn, Pd) 층에 따라 결정됩니다. 특정한 화학물질의 조성비율을 잘 맞추면 원하는 구조를 생산할 수 있습니다. 추가적으로 적당한 도금 공정을 선택하고자 한다면 가용성, 원산지, 가격, 독성, 수조 수명, 폐기물처리, 환경적 요인 등을 고려해서 생산 프로세스를 계획해야 합니다.

비전해 니켈 도금
팩텍은 웨이퍼 범핑, 패드 재표면처리(와이어본딩), ACF/ACA 적용제품을 위한 비전해 니켈도금 서비스 계약생산을 합니다. 팩텍은 전세계에 걸쳐 4개의 생산기지를 두고 있습니다. 고객의 범핑수요를 충족시킬 수 있는 설비를 갖추고 있습니다. 많은 양의 웨이퍼 범핑 뿐 아니라 프로토타입, 엔지니어링, R&D 프로젝트도 지원합니다. 팩텍 장비는 600,000웨이퍼/년 의 생산용량을 갖고 있습니다.
팩텍은 비전해 Pd와 Gold immersion 프로세스와 함께 비전해 니켈도금으로 다양한 패드 마감재와 층두께를 제공합니다.
1) e-Ni/Au
2) e-Ni/Pd
3) e-Ni/Pd/Au
적용하려는 제품에 따라 2~25µm 니켈의 두께를 조절할 수 있습니다. 팔라듐은 1000~3000A에서, 금은 300 ~1000A 에서 침착됩니다. 팩텍은 고객의 요청에 따라 두께를 조절하여 공급합니다.
Electroless Ni/Au Plating Overview 비전해 Ni/Au 도금 :
Under-Bump-Metallization (UBM) 은 범핑프로세스에서 필수불가결한 부분입니다. UBM 층은 physical vapor deposition (PVD), 전해도금, 비전해 도금될 수 있습니다. 이 세가지 방식은 비용과 신뢰성에 따라 사용방법이 달라지는데, PVD 방식은 고도의 진공상태와 포토리소그라피 과정이 필요하고 비용이 많이 드는 방법입니다. 비전해 Ni/Gold 방식은 자가 패터닝이 가능한 간단한 화학공정입니다. 따라서 초기 시설과 운영의 비용이 낮습니다.
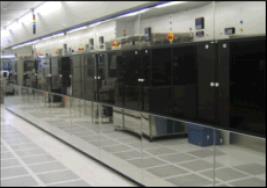 |
 |
 |
| 자동화 도금 라인(PacLine300 A50) | Aluminum Bond pad | Ni/Au 로 도금된 Bond Pad |
Process Flow: 알루미늄 반도체의 도금
1)패드 클리닝: 유기물, 실리콘산화물, 질소화홥물(용매, 용매화된 산)
2)알루미늄 에칭 : 산화알루미늄 제거(알카라인 에칭)
3)아연도금 1 :알루미늄 활성화
4)아연 제거 : 거친 아연 층 제거(강산)
5)아연도금 2 : 아연 층으로 알루미늄 활성화
6)e-Ni 도금 : 활성화된 Al 본드 패드 위에 선택적으로 니켈 침착(인산 환원제와 황산염 화합물)
7)Au and/or Pd 도금 : 니켈 층 위에 Al and/or Pd 층을 올림(시안화 또는 황산염 화합물)
알루미늄 기반 집적회로의 비전해 니켈도금은 아래와 같은 과정으로 이루어집니다.
1. 패드 위 제조과정 취급 중에 생기는 유기 또는 실리콘화합물질 제거합니다.
2. 알루미늄 패드 표면 위에 생긴 산화물질 제거. 이 과정은 부식성 에칭 화학반응으로 진행됩니다.
3. 알루미늄 표면 활성화. 산화아연 용액에서 전기화학 반응으로 알루미늄을 아연으로 치환하는 반응입니다. 아연층을 벗겨내고 다시 아연화 과정을 거치면 더 우수한 아연층이 생성됩니다. 이 과정을 "double zincation" 이라 합니다. 이 아연 층은 알루미늄 패드의 전기 포텐셜을 변화시키고, 황산니켈용액에 담그면 니켈은 아연을 치환시킵니다. 이 반응은 연속적으로 진행됩니다. 시간, 온도, pH, 니켈의 농도에 따라 1~25마이크론의 두께를 조절할 수 있습니다.
4. 대부분의 경우 니켈 도금이 완성된 뒤에 곧바로 솔더볼을 얹지 않습니다. 그럴 경우 니켈 표면은 아주 빠르게 산화됩니다. 그러므로 순수한 금속이 니켈이 산화되지 않도록 니켈표면 위에 얇게 덮여야 합니다. 그런 역할을 하는 물질이 Pd와 Au 입니다. 두 금속은 비전해 니켈프로세스와 같은 라인에서 담금 또는 비전해식으로 순차적으로 진행될 수 있습니다.
Process Flow: Plating on Copper based semiconductors 구리 기반의 반도체 도금
1)패드 클리닝: 유기물, 실리콘산화물, 질소화홥물(용매, 용매화된 산)
2)산화 구리 에칭 : 산화구리 제거(산 반응)
3)구리 에칭 : 산 반응
4) Pd 촉매 : 구리표면 촉매화(Pd 화학반응)
5)패시베이션 클리닝 : 모든 표면에서 Pd 잔유물 제거(구리 제외)
6)e-Ni 도금 : 활성화된 Al 본드 패드 위에 선택적으로 니켈 침착(인산 환원제와 황산염 화합물)
7)Au and/or Pd 도금 : 니켈 층 위에 Al and/or Pd 층을 올림(시안화 또는 황산염 화합물)
구리 기반 반도체는 알루미늄 반도체와 같은 시설의 니켈, 골드 도금조를 사용합니다. 산 처리 클리닝은 I/O패드 표면에서 산화구리와 잔여 오염물질을 제거합니다. Cu 반도체 도금의 노하우는 주변 패시베이션의 활성화 없이 구리 I/O 패드를 선택적으로 촉매화 하는 데 있습니다.
비전해 도금 과정은 비용이 낮고 플립칩, WLCSP 범핑 외에도 다양한 응용분야에 사용됩니다.
- 폴리머 플립칩(1-5µm of Ni/Au + 전도성 에폭시)
- 이방성 전도성 접착제(Anisotropic conductive adhesives (10-25µmNi/Au + ACF or ACA )
- 구리와 알루미늄 패드 표면 재처리(와이어 본드 준비, 2-5µm Ni/Au, Ni/Pd, or Ni/Pd/Au)
- 구리패드 표면 재처리(probe testing, 2-5µm Ni/Au, Ni/Pd, or Ni/Pd/Au)
- 솔더 영역을 정의하기 위한 프로세스가 필요 없음(진공 금속 증착, 포토리소그라피, 마스크 에칭에서는 필요함)
- 하나의 시스템으로 모든 사이즈의 웨이퍼 사용(3"~12") - 변경 과정 필요 없음
- 공장화 기술로서 자본투자가 상대적으로 적게 듦
- 운영비용(노동력, 유지비) 감소
도금의 품질을 결정하는 중요한 세가지 단계는 다음과 같습니다.
1.도금 프로세스 선택,
2.니켈의 형태, 구조,
3.알루미늄(구리) 패드에 니켈의 접착
최선의 니켈 도금 구조는 제련도, 균일도, 얇은 촉매(Zn, Pd) 층에 따라 결정됩니다. 특정한 화학물질의 조성비율을 잘 맞추면 원하는 구조를 생산할 수 있습니다. 추가적으로 적당한 도금 공정을 선택하고자 한다면 가용성, 원산지, 가격, 독성, 수조 수명, 폐기물처리, 환경적 요인 등을 고려해서 생산 프로세스를 계획해야 합니다.




