Solder Bumping(솔더 범핑)
Solder Bumping
팩텍은 BGA와 유사한 패키지공정과 플립칩, WLSP 적용제품에 대한 범핑 서비스를 하고 있습니다. 고객의 범핑 수요를 충족시킬 수 있는 설비를 갖추고 있습니다. 많은 양의 웨이퍼 범핑 뿐 아니라 프로토타입, 엔지니어링, R&D 프로젝트도 지원합니다.
팩텍은 비전해 니켈 도금 프로세스로 Under-Bump-Metallurgy (UBM)을 침착하고, 세가지 다른 기술로 솔더볼을 배치, 리웍합니다.링, R&D 프로젝트도 지원합니다. 1) SB² 테크놀로지 - 볼 레이저 제팅
1) SB² 테크놀로지 - 볼 레이저 제팅
팩텍은 비전해 니켈 도금 프로세스로 Under-Bump-Metallurgy (UBM)을 침착하고, 세가지 다른 기술로 솔더볼을 배치, 리웍합니다.링, R&D 프로젝트도 지원합니다.

2)울트라 SB² 테크놀로지 - 솔더구 이송
3)솔더 볼 리웍(제거, 재장착)
아래의 표는 생산형태와 범프 높이, 패드간격, 크기에 따른 장치의 선택 기준을 보여줍니다.
팩텍 제조공장에서 웨이퍼 레벨 범핑의 표준공정은 다음과 같습니다.
1)수화물 도착 : 포장을 풀고 작업준비
2)웨이퍼 검사
3)비전해 니켈 UBM 침착(e-Ni 섹션 참조)
4)플럭스와 솔더 배치(세가지 방법 중 한가지가 위에 서술)
5)리플로우
6)웨이퍼 세정
7) 계측(범프 높이, 범프 전단력, 수율 검사)
8) 출하될 웨이퍼 검사
9) 배송 : 패키지, 서류작업(리포트, 데이타 파일)
Flip Chip Bumping and WLCSP Bumping Overview:
웨이퍼 범핑은 플립칩범핑(FC)과 wafer level chip scale packaging (WLCSP)로 나눌 수 있습니다. 이런 세분화된 명명법은 솔더범프의 크기와 범프를 생성하는 장비의 형태에 따라 나뉘어 집니다.
플립칩 범프는 칩과 기판 사이에 underfill material이 채워지는 높이 50 ~ 200 µm 의 반도체 웨이퍼 범프이고, WLCSP 범프는 높이 200 ~ 500 µm 이고 언더필이 필요 없는 범프입니다.
웨이퍼 본드패드 위에 금속 장벽(UBM)을 배치하고 솔더볼을 배치합니다.


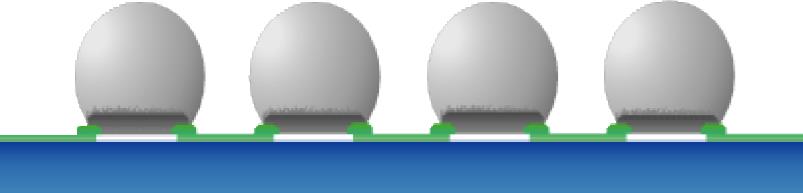
Wafer Bond Pads e-Ni/Au Plated UBM Solder Deposition
팩텍이 보유한 두 가지 솔더 배치 기술에 대한 내용은 아래와 같습니다.
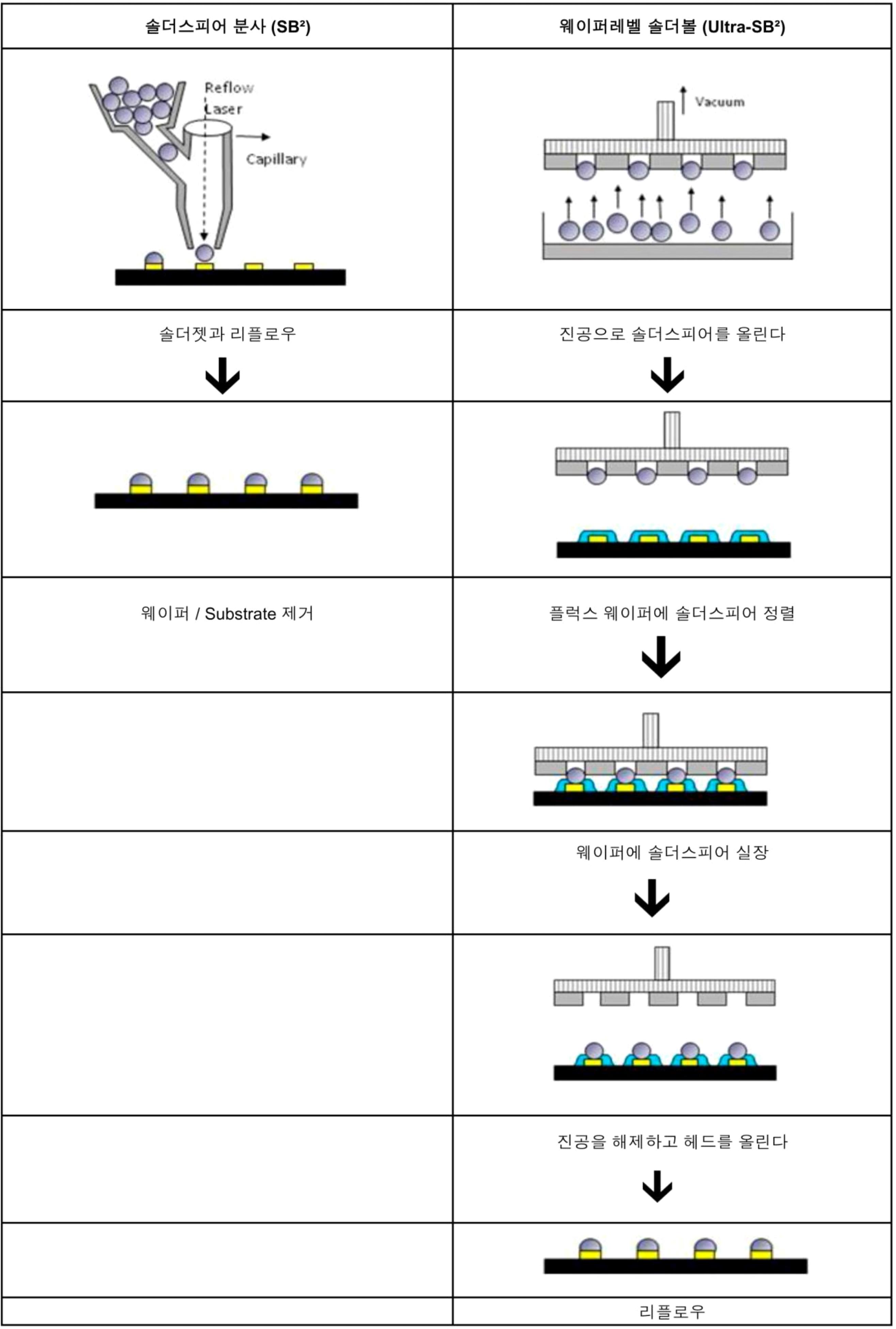
팩텍에서 사용하는 솔더 합금 :
SnAgCu (SAC305, SAC405, SAC105)
SnAg
PbSn 95/5, PbSn 90/10
AuSn 80/20
InSn
SnBi
3)솔더 볼 리웍(제거, 재장착)
아래의 표는 생산형태와 범프 높이, 패드간격, 크기에 따른 장치의 선택 기준을 보여줍니다.
| Solder Sphere Jetting (SB²) | Wafer Level Solder Balling (Ultra-SB²) | Solder Deballing/Rework | |
| Product Types | Prototype Wafers | High Volume Wafer Level Solder Bumping | |
| Low I/O Count Wafers | High I/O Applications | BGA | |
| Low Volume Wafers for Medical | High yield applicatins | cLCC | |
| Low Volume Wafers for Military | CSP | ||
| Low Volume ASIC Wafers | etc. | ||
| Probe Cards | |||
| MEMS | |||
| Hard Disc Drives | |||
| Camera Modules | |||
| 3D Packaging | |||
| BGA, CSP, cLCC etc. | |||
| Solder Bump Height | 40 - 760um | 60 - 760 um | 150 - 760um |
| Smallest Bump Pitch | 80um | 80um | 200um |
| Throughput | 7 balls/second | 25-30 wafers/hr | 1 ball/sec |
팩텍 제조공장에서 웨이퍼 레벨 범핑의 표준공정은 다음과 같습니다.
1)수화물 도착 : 포장을 풀고 작업준비
2)웨이퍼 검사
3)비전해 니켈 UBM 침착(e-Ni 섹션 참조)
4)플럭스와 솔더 배치(세가지 방법 중 한가지가 위에 서술)
5)리플로우
6)웨이퍼 세정
7) 계측(범프 높이, 범프 전단력, 수율 검사)
8) 출하될 웨이퍼 검사
9) 배송 : 패키지, 서류작업(리포트, 데이타 파일)
Flip Chip Bumping and WLCSP Bumping Overview:
웨이퍼 범핑은 플립칩범핑(FC)과 wafer level chip scale packaging (WLCSP)로 나눌 수 있습니다. 이런 세분화된 명명법은 솔더범프의 크기와 범프를 생성하는 장비의 형태에 따라 나뉘어 집니다.
플립칩 범프는 칩과 기판 사이에 underfill material이 채워지는 높이 50 ~ 200 µm 의 반도체 웨이퍼 범프이고, WLCSP 범프는 높이 200 ~ 500 µm 이고 언더필이 필요 없는 범프입니다.
웨이퍼 본드패드 위에 금속 장벽(UBM)을 배치하고 솔더볼을 배치합니다.


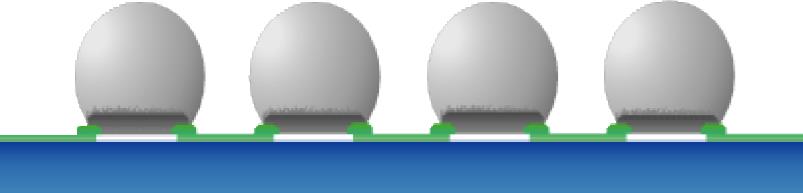
Wafer Bond Pads e-Ni/Au Plated UBM Solder Deposition
팩텍이 보유한 두 가지 솔더 배치 기술에 대한 내용은 아래와 같습니다.
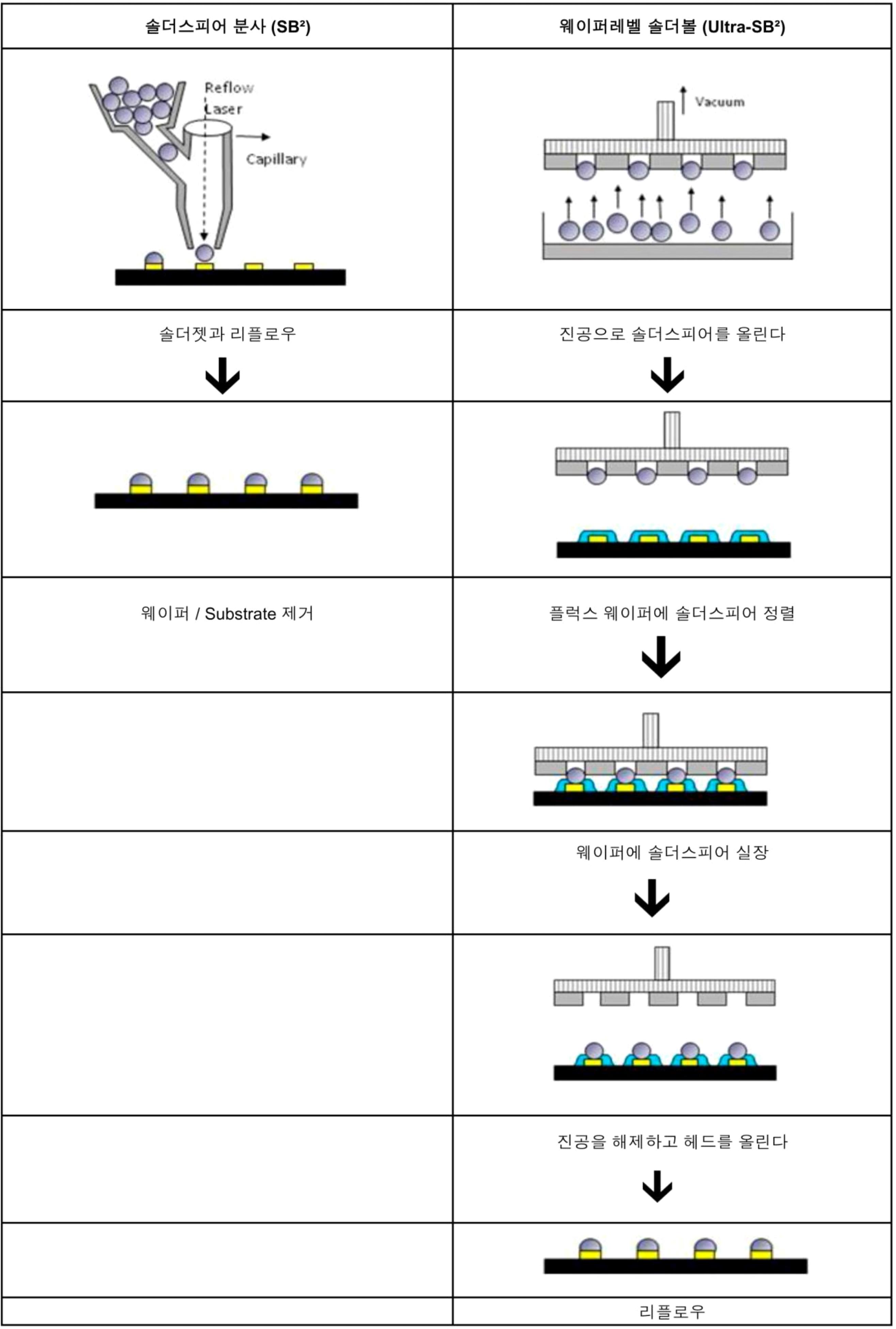
팩텍에서 사용하는 솔더 합금 :
SnAgCu (SAC305, SAC405, SAC105)
SnAg
PbSn 95/5, PbSn 90/10
AuSn 80/20
InSn
SnBi




